|
2.4 Multilayer(多層配線)
多層基板・多層配線の技術は,2.3のマスタスライス三次元MMICやSOCなどの半導体ICに限ったものではない.例えば2.2で述べたSOPの基板などには,通常,多層基板が用いられる.多層基板にはいろいろ種類があるが,高周波回路用としては,低温焼成基板LTCC(Low
Temperature Co-fired Ceramics),高温焼成基板HTCC(High Temperature Co-fired Ceramics)がよく用いられる.電気的な側面から多層基板,多層配線を見ると,やはり伝送線路としてどういう特性を有しているのか,どういった線路が適切であるのか,解析法も含めて興味のあるところである.また多層基板,多層配線の特徴を生かした受動回路素子もいろいろ提案されている.
図6は多層基板,多層配線の特徴を生かした受動回路素子の例であり,バラン用の1対のスパイラルインダクタ(11),ランゲカップラ(12),ダイプレクサ(13)
が多層基板上に形成されている.スパイラルインダクタはSi基板上にポリイミドを2層重ね,その上に銅配線を施して作っている.ランゲカップラはアルミナ基板上にBCB(Benzocyclobutene)を2層重ね,その上に銅配線を施して作っている.ダイプレクサは,5層のLTCC基板上に銅配線を施して作っている.
|
|
|
|
(a-1) チップ写真
|
(b) 多層ランゲカップラ
|
|
|
|
|
(a-2) 断面図
|
|
|
(a) 多層スパイラルインダクタ
|
(c) 多層ダイプレクサ
|
図6 多層基板,多層配線の特徴を生かした受動回路素子の例(11)~(13)
多層基板・多層配線の課題は,多層基板,多層配線で作れない受動回路素子や能動回路素子をどう集積化していくかである.現状では表面実装で対応しているが,将来的には更なる高集積化のために,受動回路素子や能動回路素子を埋め込む(内蔵する)方向で進んでいる.
2.5 MEMS(Micro ElectroMechanical System)
MEMSはこれまで不可能であったいろいろなJisso技術を可能にする.一つは半導体プロセスを用いた微細加工(マイクロマシン)技術を駆使することによって,機械的な要素を付け加えることができる.他の一つは,これまでの伝送線路のイメージであった平らな基板をいろいろな形に加工することができる.前者はSurface
Micromachiningと呼ばれ,RF MEMSスイッチや移相器が代表的なものである.後者はBulk Micromachiningと呼ばれ,可変キャパシタやインダクタが代表的なものである.図7にRF
MEMSの例を示す(14).前者は図7のExtrinsicの部分であり,Si,水晶,セラミックといった基板の表面に半導体技術を用いて超小型回路を形成している.比較的高い電圧を印加して機械的な動作をさせるため,スピードは遅いが損失が極めて少ないのが特徴である.後者は図7のIntrinsicの部分であり,バルクそのものをエッチングにより加工し,いろいろな形を作っている.それらは加速度センサ,圧力センサ,インクジェットのノズルなどに応用されている.図7にはその他のMEMSデバイスとして,Reactiveな部分,MEMS基板を利用したRFデバイスと基板の表面に形成したアクチュエータと組み合わせたMEMSフィルタを紹介している.このように,RF
MEMSはこれまでにないJisso技術を提供することができるため,新たなRFデバイスを実現できる可能性が高い.しかしRF MEMS開発は始まったばかりであるために,回路設計から製造までにおいて課題は山積している.
| RF MEMS カテゴリー |
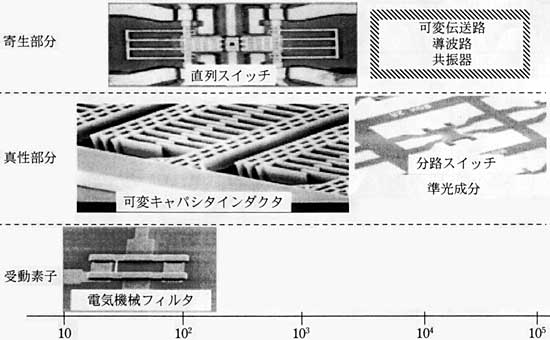 |
|
周波数 (MHz)
|
図7 RF
MEMSの例(14)
|